【前編】第26回 プリント配線板EXPO 出展レポート

東京ビッグサイトで2025年1月22日(水)~24日(金)に開催された、
ネプコンジャパン「第26回プリント配線板EXPO」に出展いたしました。
多くのお客様に弊社ブースにお立ち寄りいただき盛況の内に終了することができました。
誠にありがとうございました。
展示会全体としても3日間にわたって8万名を超える来場数だったこともあり、
弊社のブースも開始から終了までほとんどの時間お客様で賑わっておりました。
その様子を前後編にわたり、レポートしたいと思います。
まずは、ブース全体の様子を動画でご紹介します。
次に主な展示品をいくつかご紹介させていただきます。
【高多層・高周波】貫通スルーホールもフィルドビアも問題なし!
◎ビルドアップ基板
5G・M2M・サーバーの高速化に適した「低誘電率/低誘電正接」材料を使用して、低層(1-2-1:4層)
から高多層(3-6-3:12層以下)まで対応可能。Fill-Via採用によりフルスタックにも対応。
4段R-1566材は量産対応可能。低損失材 試作検討中。
国内外の低誘電材料を検討しているお客様の要望にお応えします。
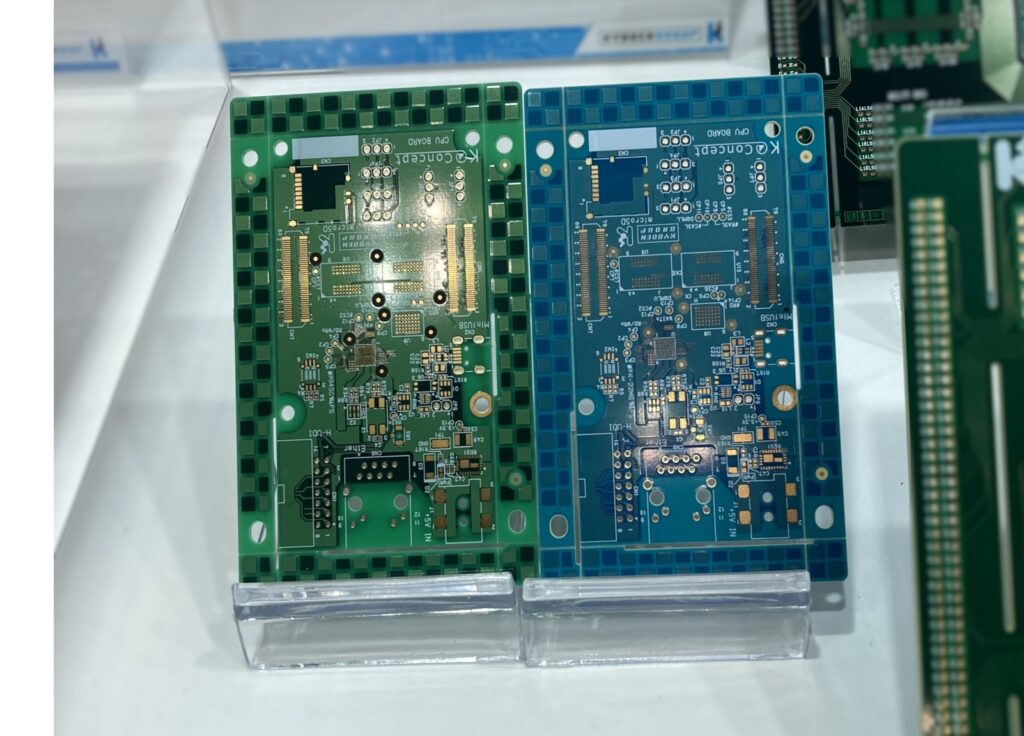
ビルドアップ基板 6層(2-2-2)
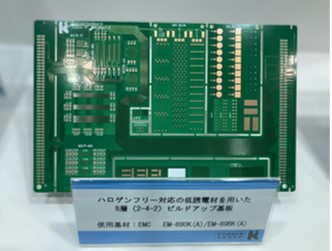
ビルドアップ基板 8層(2-4-2)
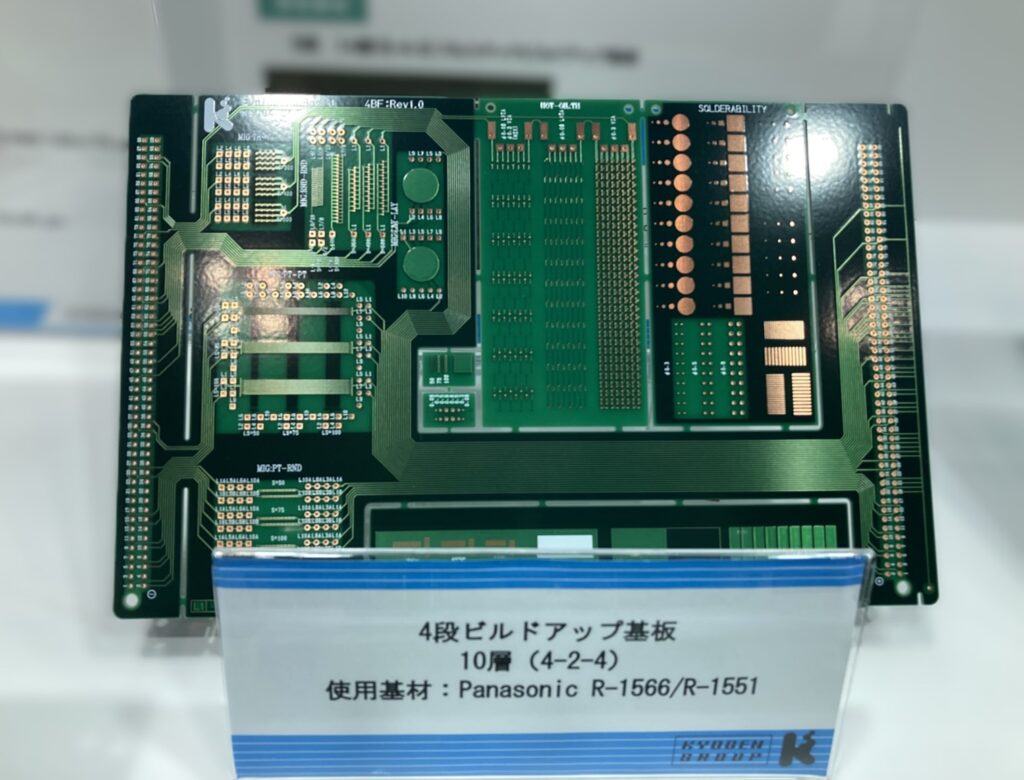
10層(4-2-4)
弊社のビルドアップ基板製造事例を含めた無料ブックをご用意しております。ぜひご覧ください

◎高多層基板
5G・M2M・サーバーの高速化に適した「低誘電率/低誘電正接」材料を使用して、低層(2層)から
高多層(30層以下)まで量産対応可能。※30層超は仕様により要相談
国内外の低誘電材料を検討しているお客様の要望にお応えします。

生益化技材 S1000-2/S1000-2B
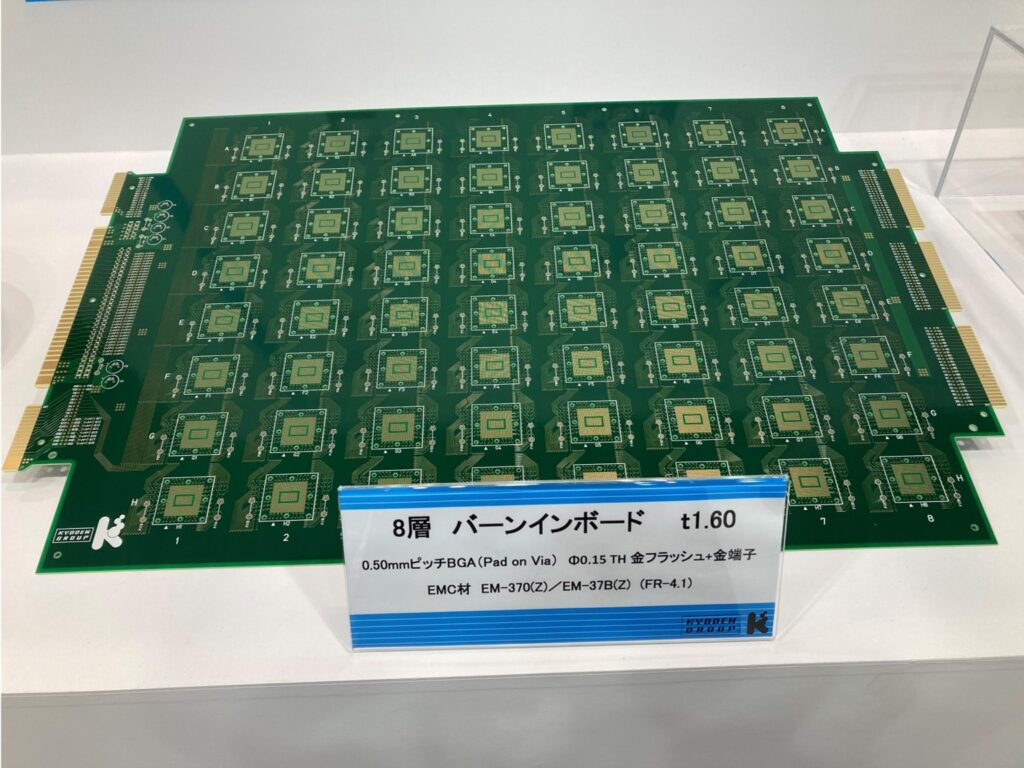
EMC材 EM-370(Z)/EM-37B(Z)

panasonic材 R-1766/R-1661
【高放熱・大電流】高速厚銅技術で高放熱を実現
◎高周波高放熱基板
パワー半導体、高放熱高周波部品の放熱対策に貢献。高速厚銅めっき工法による高放熱基板の開発
部品の発熱を導体へ逃がすような回路を、プリント基板上に厚銅めっきで形成。
他工法に比べ、放熱回路の設計自由度が得られます。
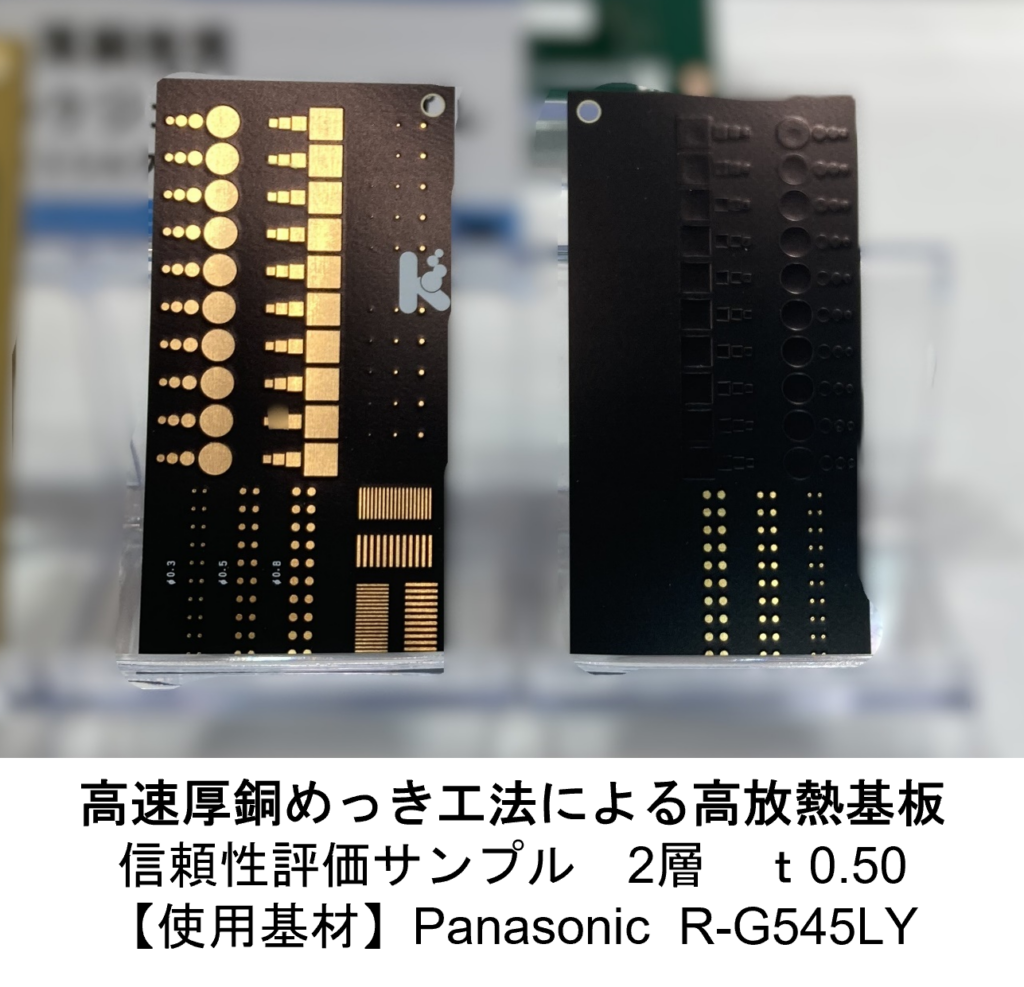
高周波特性を落とさず、優れた放熱特性が得られるため、放熱特性の向上による部品劣化を低減、また配線距離(配線長)を狭めて伝送損失を低減します。
銅めっきで形成するため、他工法(銅インレイ等)に
比べて異形状にも対応しやすく、銅インレイや銅コイン等では対応が難しい薄板への運用が可能です。
◎大電流・コイル基板
電動化や大電流・放熱対策に寄与します⇒ 導体厚の増加 CCLでは210μmまで対応可能
厚銅配線により発熱を抑え且つ、高多層化も実現します。
設計~実装まで一貫対応し、ワイヤレス伝送による受給電実現による稼働率の向上が見込めます。
インクジェットシルク適用により従来印刷では難しい厚導体にも対応です。

コイル基板・制御回路基板

実装・組立

シルクインクジェットサンプル
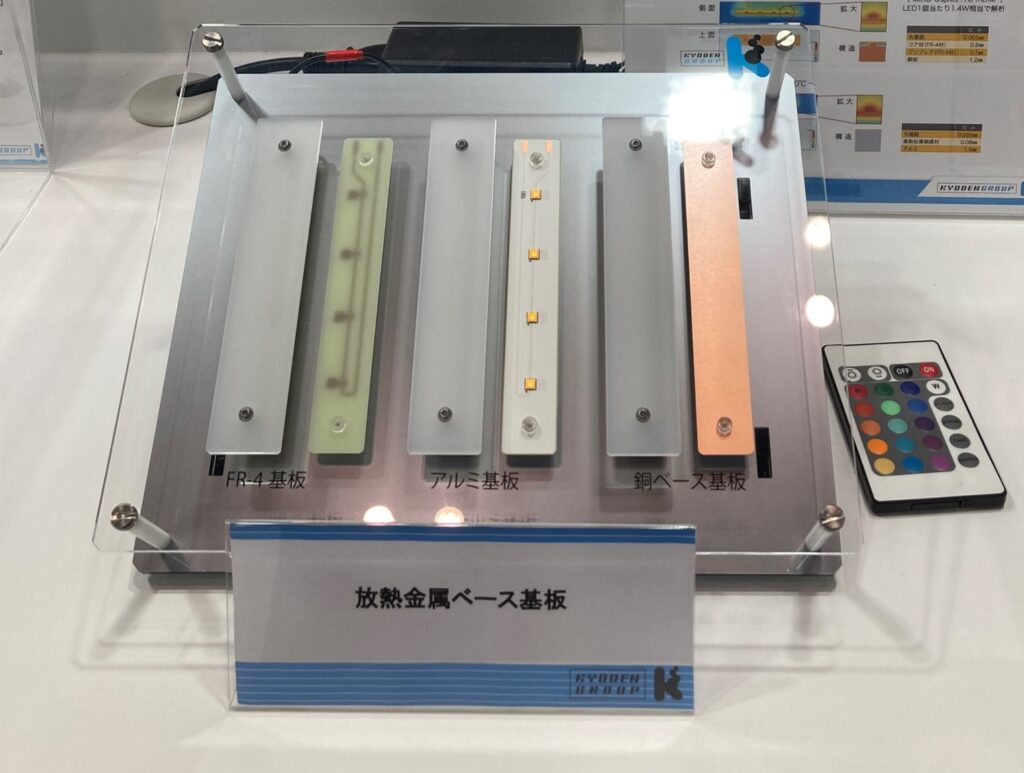


【実装・メカ部品】部品調達にも自信があります。お任せください!
◎部品実装・筐体・板金・射出成形
大型基板から高密度実装まであらゆる製品の実装実績があり、最新設備と最先端技術で高難易度の実装にも対応可能です。大型重量超多ピンFPGAの実装も実績がございます。

狭隣接実装技術 0402チップ
ハイスピード実装動画【部品間ピッチ0.15mm】
また、メカに関しても筐体設計、プレス・板金加工・樹脂成形・切削加工まで、すべてお任せください。
部品単品はもちろん、成形品+板金部品等を組合わせたアッセンブリーにも対応可能です。


バスバー シートメタル

溶接(鉄/アルミ/ステンレス)
ろう付け(銅)
前編はここまでです。続く後編もぜひご覧ください!



