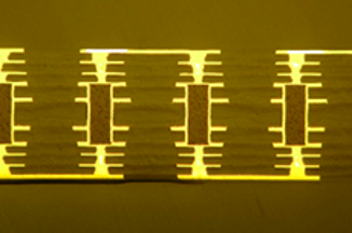
ビルドアップ基板
コア層の上に導体を1層ずつ積み上げて、多層化したプリント基板。穴あけ加工、配線・ビア形成などを繰り返して製造する多層構造のプリント基板。
小径形成可能なレーザービア技術とフィルドめっき技術を使用してビルドアップ層とコア層における多様な層構成が構築可能。その為、多層貫通プリント基板に比べ設計の自由度が高く、製品の小型化・薄型化に適しています。
特長
- 貫通TH基板に比べ、基板の小型化が可能。
- 貫通VIAレスの場合、導体厚を抑えられることから表面実装に際して表層平坦化のメリット。
- 層間厚が薄い為、伝送損失が少なく高速伝送用途に最適。
- ビルド層は、1層毎に層間接続を行う事が出来る為にその上部(層)にも配線可能となり、高密度化を実現出来ます。
キョウデンの強み
- ビルド層をフィルドビアによるフルスタック構造にすることで配線自由度が向上します。
- 基材在庫、豊富な試作実績によりお客様の希望する特性基材を提案します。
- 極薄部材による極薄ファイン対応が可能。(最薄板厚0.40mm 可能(1-2-1))
- 1-2-1(4層ビルドアップ基板)を最短2日で納品。
- レーザー加工機最新機種導入、ビアフィルめっきラインも内製化。安定品質を実現。
- ビルドアップ製造工場は2工場体制。BCP観点でも安心。
主な製品用途
- スマートフォン、タブレット、ノートPC等の携帯情報通信機器



